氧化铪(HfO2)基铁电存储器在CMOS工艺兼容性、可微缩性、功耗和擦写速度等方面具备显著的优势,成为新型非易失性存储器中重要的候选者。过去的十多年来,针对铪基铁电薄膜材料的研究多通过引入掺杂以增强其铁电性能。但制备工艺的多样性,器件间涨落问题以及掺杂特性提升的局限性,成为其在新型非易失性存储器领域应用发展面临的关键问题。
针对这些问题,研究团队受早期关于纯单晶HfO2薄膜中铁电相讨论的启发,结合前期关于无掺杂HfO2薄膜铁电特性的实验报道,开展无掺杂HfO2薄膜的铁电特性调控机制与工艺方法研究,并通过建立起完备的特性评估规则来为工艺窗口的设计优化提供理论指导,从而在繁复的材料特征中探明铪基材料铁电性的真实根源。
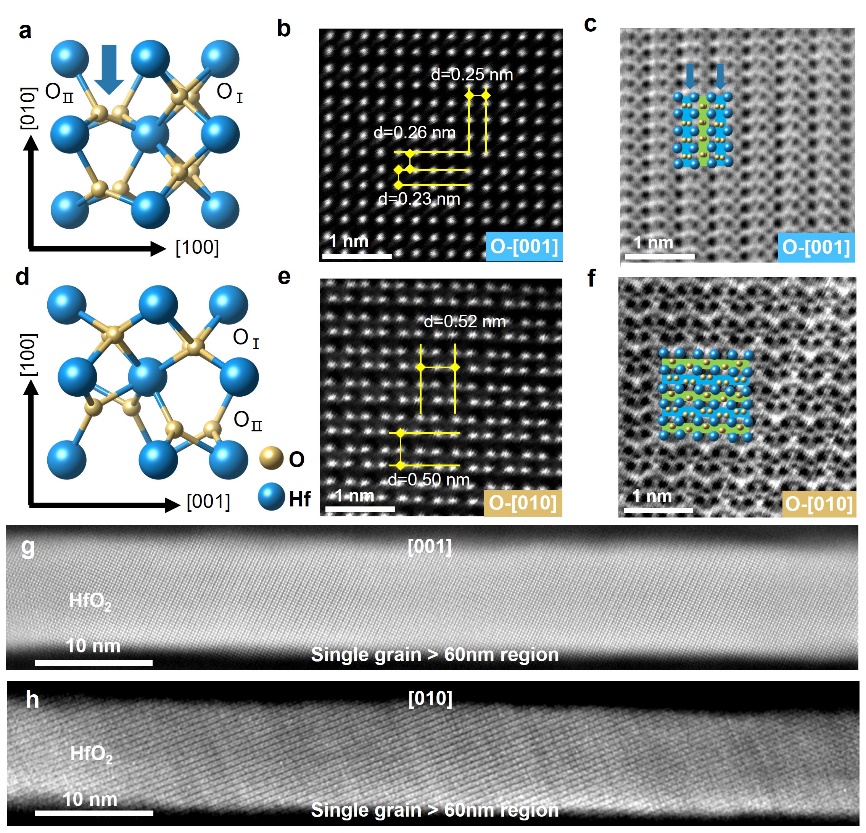
图1. 无掺杂HfO2铁电薄膜的微观结构表征
该研究从HfO2铁电材料的微观结构出发,分析了不同ALD工艺和前驱体制备的HfO2薄膜中铁电相籽晶产生方式和分布特点,指出掺杂和等离子体造成的晶格缺陷均能成为结晶核,从而促进薄膜中纳米铁电籽晶的形成,为HfO2铁电薄膜材料的制备提供了统一的思路。在纳米籽晶形成机制研究方面,阐明了氧等离子体作用下初始沉积层的结晶特性演变规律。研究证实,氧等离子体在初始沉积薄膜中由引入了主要以单斜相或四方相存在的纳米籽晶。通过调节氧分压,可以提高籽晶形成的比例,在经金属沉积后退火处理后提高了铁电极化相的比例和尺寸(> 60 nm)。

图2. 无掺杂HfO2铁电器件电学特性测试
对器件的电学特性和可靠性进行测试,展示了非常理想的耐久特性(> 1011)和保持特性(> 10年)。最值得关注的是,利用快速脉冲方法对器件的极化翻转速度进行测试,获得了接近1 ns的超快极化翻转速度。对翻转动力学进行分析,发现存在NLS模型向KAI模型转变的动力学过程,表明了大尺寸晶粒对翻转速度的提升,也间接证明了初始薄膜沉积的连续性和均匀性。此外,采用随机抽样对器件特性涨落进行表征,结果显示无掺杂HfO2铁电器件具有良好的D2D均匀性。最后,对器件进行漏电测试,初始极化条件下展示了非常低的漏电流,表明无掺杂HfO2具有良好的界面特性和非常低的缺陷浓度。
相关成果以“Ultrafast Switching Speed Demonstrated in Wafer-Scale Integration of Crystalline Undoped HfO2‑Based Ferroelectrics”为题,发表在《Nano Letters》上(https://doi.org/10.1021/acs.nanolett.4c05765)。北京大学集成电路学院2021级博士研究生尚宗伟、华东师范大学李晓梅副教授为共同第一作者,北京大学黎明研究员和王润声教授、华东师范大学吴幸教授为共同通讯作者。以上研究工作得到了国家自然科学基金、111计划和北京高等学校卓越青年科学家计划等项目支持。